SiO2薄膜的刻蚀机理
时间:2024-12-31 22:55:05 359浏览 收藏
你在学习科技周边相关的知识吗?本文《SiO2薄膜的刻蚀机理》,主要介绍的内容就涉及到,如果你想提升自己的开发能力,就不要错过这篇文章,大家要知道编程理论基础和实战操作都是不可或缺的哦!
本文探讨二氧化硅(SiO2)薄膜的干法刻蚀机理。 干法刻蚀SiO2的化学反应过程如何进行?其化学方程式是什么?
以常用的氟系气体为例,其刻蚀反应可简述如下:
SiO₂薄膜的干法刻蚀并非单纯的化学反应,而是物理轰击和化学反应的协同作用。 反应式如下:
SiO₂(s) + CxFy + Ar⁺ → SiF₄(g) + CO(g)
其中:
- SiO₂(s):固态二氧化硅
- CxFy:来自刻蚀气体(如CF₄、CHF₃)的氟自由基,是化学刻蚀的活性物质。
- Ar⁺:加速的高能氩离子,提供物理轰击作用。
- SiF₄(g):气态四氟化硅,是主要的挥发性产物。
- CO(g):气态一氧化碳,是副产物。
下图所示,红色箭头表示高能氩离子(Ar⁺)的物理轰击,它破坏SiO₂表面的键,增加反应位点,并增强刻蚀的各向异性。绿色箭头代表氟自由基(CxFy)的化学反应。 高效刻蚀依赖于离子轰击和化学反应的协同作用,单纯的物理或化学方法都无法达到高效刻蚀的效果。
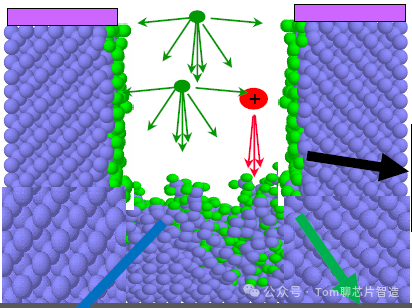
离子与中性粒子(自由基)的比例对刻蚀速率有显著影响。
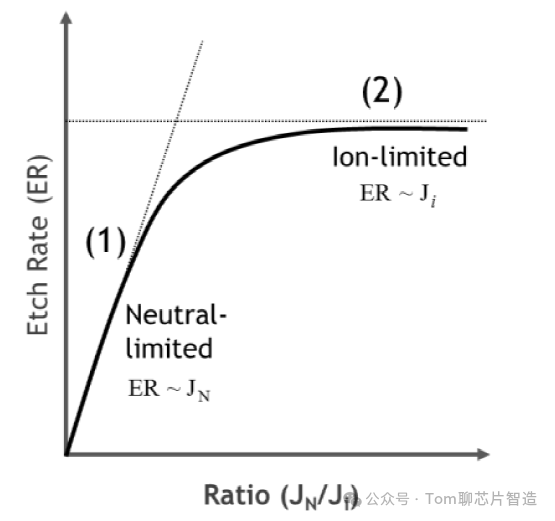
如上图所示,当Ar⁺离子与CxFy自由基的比例较低时,刻蚀速率主要受自由基浓度限制;当比例较高时,Ar⁺离子轰击成为限制因素,刻蚀速率趋于饱和。
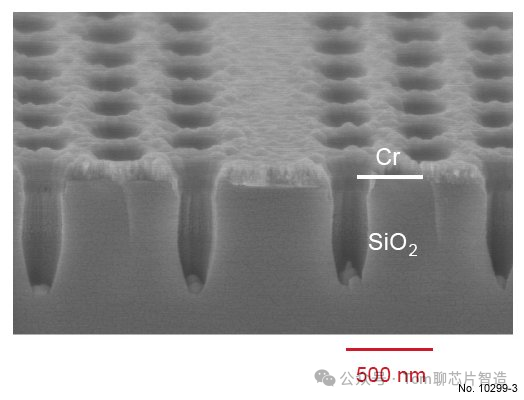
今天关于《SiO2薄膜的刻蚀机理》的内容介绍就到此结束,如果有什么疑问或者建议,可以在golang学习网公众号下多多回复交流;文中若有不正之处,也希望回复留言以告知!
相关阅读
更多>
-
501 收藏
-
501 收藏
-
501 收藏
-
501 收藏
-
501 收藏
最新阅读
更多>
-
199 收藏
-
412 收藏
-
149 收藏
-
274 收藏
-
436 收藏
-
258 收藏
-
494 收藏
-
187 收藏
-
414 收藏
-
159 收藏
-
430 收藏
-
223 收藏
课程推荐
更多>
-

- 前端进阶之JavaScript设计模式
- 设计模式是开发人员在软件开发过程中面临一般问题时的解决方案,代表了最佳的实践。本课程的主打内容包括JS常见设计模式以及具体应用场景,打造一站式知识长龙服务,适合有JS基础的同学学习。
- 立即学习 543次学习
-

- GO语言核心编程课程
- 本课程采用真实案例,全面具体可落地,从理论到实践,一步一步将GO核心编程技术、编程思想、底层实现融会贯通,使学习者贴近时代脉搏,做IT互联网时代的弄潮儿。
- 立即学习 516次学习
-

- 简单聊聊mysql8与网络通信
- 如有问题加微信:Le-studyg;在课程中,我们将首先介绍MySQL8的新特性,包括性能优化、安全增强、新数据类型等,帮助学生快速熟悉MySQL8的最新功能。接着,我们将深入解析MySQL的网络通信机制,包括协议、连接管理、数据传输等,让
- 立即学习 500次学习
-

- JavaScript正则表达式基础与实战
- 在任何一门编程语言中,正则表达式,都是一项重要的知识,它提供了高效的字符串匹配与捕获机制,可以极大的简化程序设计。
- 立即学习 487次学习
-

- 从零制作响应式网站—Grid布局
- 本系列教程将展示从零制作一个假想的网络科技公司官网,分为导航,轮播,关于我们,成功案例,服务流程,团队介绍,数据部分,公司动态,底部信息等内容区块。网站整体采用CSSGrid布局,支持响应式,有流畅过渡和展现动画。
- 立即学习 485次学习

