英特尔计划在2025年前将其3D Foveros封装产能提升至四倍
来源:IT之家
时间:2023-08-25 17:17:07 121浏览 收藏
对于一个科技周边开发者来说,牢固扎实的基础是十分重要的,golang学习网就来带大家一点点的掌握基础知识点。今天本篇文章带大家了解《英特尔计划在2025年前将其3D Foveros封装产能提升至四倍》,主要介绍了,希望对大家的知识积累有所帮助,快点收藏起来吧,否则需要时就找不到了!
本站 8 月 22 日消息,英特尔正在积极投入先进制程研发,也同步强化其先进封装业务,目前正在马来西亚槟城兴建最新的封装厂,强化 2.5D / 3D 封装布局版图。
该公司表示,规划到 2025 年时,其 3D Foveros 封装的产能将增加四倍。英特尔副总裁 Robin Martin 今日在槟城受访时透露,未来槟城新厂将会成为该公司最大的 3D 先进封装据点。
2021 年,英特尔宣布将投资 71 亿美元(本站备注:当前约 517.59 亿元人民币)在槟城峇六拜建造一家由英特尔运营的全新领先半导体封装工厂。
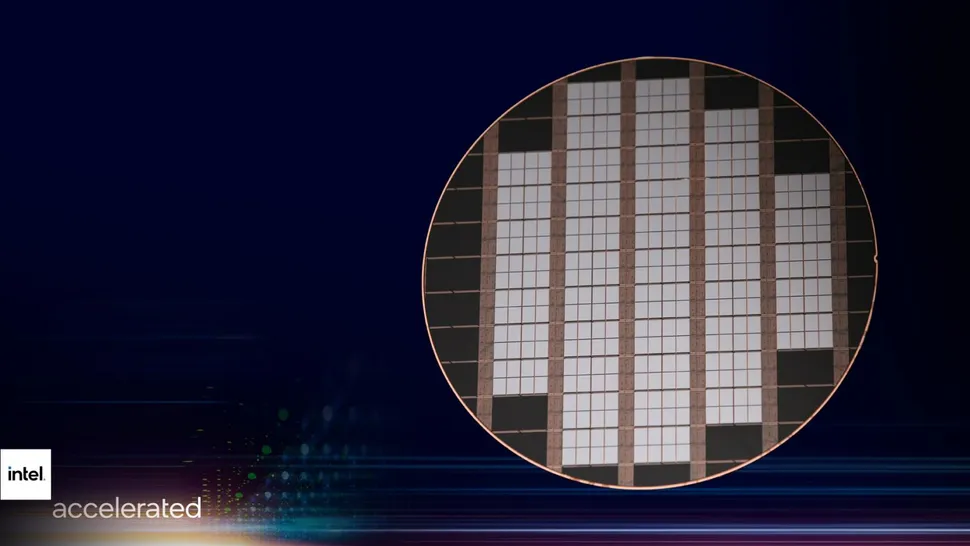
根据英特尔的说法,芯片的封装作为处理器和主板之间的物理接口,在产品级性能方面起着至关重要的作用。先进的封装技术能够方便各种计算引擎实现多进程技术的集成,并有助于在系统架构中采用全新的方法
据介绍,英特尔的Foveros封装技术采用3D堆栈来实现逻辑对逻辑的集成,为设计人员提供了极大的灵活性,从而在新设备外形要素中混搭使用技术IP块与各种内存和输入/输出元素。产品可以分成更小的小芯片(chiplet)或块(tile),其中I/O、SRAM和电源传输电路在基础芯片中制造,高性能逻辑小芯片或块堆叠在顶部
除此之外,英特尔的全新封装功能正在解锁新的设计,通过将 EMIB 和 Foveros 技术相结合,允许不同的小芯片和块互连,性能基本上相当于单个芯片。凭借 Foveros Omni,英特尔称设计人员利用封装中的小芯片或块可获得更大的通信灵活性。
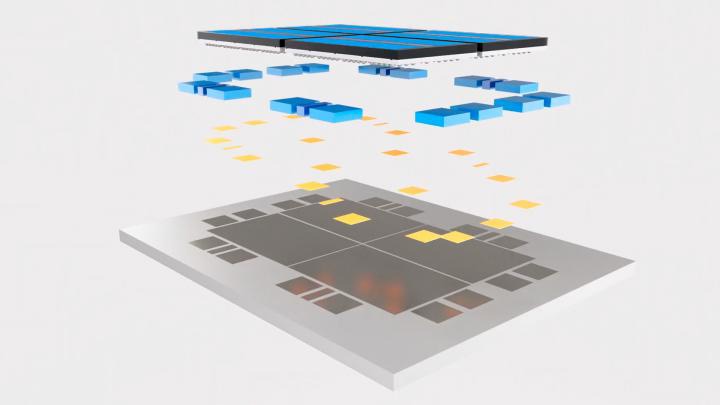
广告声明:本文中包含对外跳转链接(包括但不限于超链接、二维码、口令等形式),旨在提供更多信息,节省筛选时间,仅供参考。请注意,本站的所有文章都包含此声明
终于介绍完啦!小伙伴们,这篇关于《英特尔计划在2025年前将其3D Foveros封装产能提升至四倍》的介绍应该让你收获多多了吧!欢迎大家收藏或分享给更多需要学习的朋友吧~golang学习网公众号也会发布科技周边相关知识,快来关注吧!
-
501 收藏
-
501 收藏
-
501 收藏
-
501 收藏
-
501 收藏
-
155 收藏
-
134 收藏
-
158 收藏
-
218 收藏
-
105 收藏
-
365 收藏
-
226 收藏
-
377 收藏
-
349 收藏
-
150 收藏
-
199 收藏
-
344 收藏
-

- 前端进阶之JavaScript设计模式
- 设计模式是开发人员在软件开发过程中面临一般问题时的解决方案,代表了最佳的实践。本课程的主打内容包括JS常见设计模式以及具体应用场景,打造一站式知识长龙服务,适合有JS基础的同学学习。
- 立即学习 543次学习
-

- GO语言核心编程课程
- 本课程采用真实案例,全面具体可落地,从理论到实践,一步一步将GO核心编程技术、编程思想、底层实现融会贯通,使学习者贴近时代脉搏,做IT互联网时代的弄潮儿。
- 立即学习 516次学习
-

- 简单聊聊mysql8与网络通信
- 如有问题加微信:Le-studyg;在课程中,我们将首先介绍MySQL8的新特性,包括性能优化、安全增强、新数据类型等,帮助学生快速熟悉MySQL8的最新功能。接着,我们将深入解析MySQL的网络通信机制,包括协议、连接管理、数据传输等,让
- 立即学习 500次学习
-

- JavaScript正则表达式基础与实战
- 在任何一门编程语言中,正则表达式,都是一项重要的知识,它提供了高效的字符串匹配与捕获机制,可以极大的简化程序设计。
- 立即学习 487次学习
-

- 从零制作响应式网站—Grid布局
- 本系列教程将展示从零制作一个假想的网络科技公司官网,分为导航,轮播,关于我们,成功案例,服务流程,团队介绍,数据部分,公司动态,底部信息等内容区块。网站整体采用CSSGrid布局,支持响应式,有流畅过渡和展现动画。
- 立即学习 485次学习

